在SMT貼片加工與PCBA制造領(lǐng)域,BGA(球柵陣列封裝)因高密度、高可靠性被廣泛應(yīng)用,但其焊點(diǎn)隱藏于元件底部,傳統(tǒng)目視檢測(cè)無(wú)法覆蓋內(nèi)部缺陷。因此,建立一套從表面到內(nèi)部、非破壞到破壞的完整檢驗(yàn)體系,是SMT貼片廠(chǎng)保障PCBA質(zhì)量的關(guān)鍵。我們將分享BGA焊點(diǎn)質(zhì)量檢驗(yàn)的核心方法,助力企業(yè)精準(zhǔn)識(shí)別缺陷、提升工藝穩(wěn)定性。
一、BGA焊點(diǎn)缺陷的風(fēng)險(xiǎn):為何檢驗(yàn)不可忽視?
BGA焊點(diǎn)通過(guò)芯片底部錫球與PCB焊盤(pán)連接,其內(nèi)部或表面缺陷(如空洞、虛焊、短路、裂縫)可能導(dǎo)致電氣失效(信號(hào)干擾、開(kāi)路)、機(jī)械松動(dòng)(振動(dòng)脫落)或長(zhǎng)期可靠性問(wèn)題(熱積累燒毀)。例如,焊點(diǎn)內(nèi)部空洞會(huì)減少有效焊接面積,導(dǎo)致熱阻升高,長(zhǎng)期使用可能引發(fā)元件過(guò)熱;虛焊則會(huì)造成電路時(shí)通時(shí)斷,影響產(chǎn)品功能。因此,嚴(yán)格的焊點(diǎn)檢驗(yàn)是SMT貼片廠(chǎng)避免批量報(bào)廢、降低售后風(fēng)險(xiǎn)的核心環(huán)節(jié)。
二、非破壞性檢測(cè):批量生產(chǎn)的快速篩查利器
非破壞性檢測(cè)適用于生產(chǎn)線(xiàn)上的快速篩選,不損壞元件或PCB,主要覆蓋表面與內(nèi)部可見(jiàn)缺陷,是SMT貼片廠(chǎng)日常質(zhì)量控制的基礎(chǔ)。
1. 目視/自動(dòng)光學(xué)檢測(cè)(AOI):表面缺陷的“第一道關(guān)”
- 原理:通過(guò)肉眼或高分辨率相機(jī)觀(guān)察焊點(diǎn)表面形態(tài),識(shí)別明顯缺陷。
- 檢測(cè)內(nèi)容:
- 目視:借助10-20倍放大鏡或50-100倍顯微鏡,檢查BGA貼裝位置(偏移量是否超標(biāo))、錫球形態(tài)(是否變形/缺失)、焊點(diǎn)表面(是否有連焊、助焊劑殘留)。例如,BGA貼裝偏移超過(guò)0.1mm(IPC-a-610g標(biāo)準(zhǔn))即判定為不合格。
- AOI:利用圖像識(shí)別技術(shù),通過(guò)多角度相機(jī)掃描BGA底部焊球,自動(dòng)對(duì)比標(biāo)準(zhǔn)圖像,檢測(cè)少錫/多錫(錫球大小不均)、立碑現(xiàn)象(元件一端翹起)、焊盤(pán)偏移(焊球與焊盤(pán)對(duì)齊度)。AOI檢測(cè)速度可達(dá)每秒數(shù)個(gè)元件,適合大規(guī)模生產(chǎn)。
- 優(yōu)勢(shì):速度快、成本低,能快速攔截表面缺陷;
- 局限:僅能檢測(cè)表面問(wèn)題,無(wú)法發(fā)現(xiàn)內(nèi)部空洞或虛焊。

2. X-Ray檢測(cè):內(nèi)部缺陷的“透視鏡”
X-Ray檢測(cè)是BGA焊點(diǎn)內(nèi)部缺陷檢測(cè)的核心非破壞方法,通過(guò)x射線(xiàn)穿透PCB,顯示焊點(diǎn)內(nèi)部結(jié)構(gòu),適用于高可靠性產(chǎn)品(如工業(yè)控制、醫(yī)療設(shè)備)。
- 類(lèi)型與原理:
- X-Ray:將三維焊點(diǎn)投影為二維圖像,可清晰觀(guān)察空洞位置(如錫球中心/邊緣)、虛焊(焊球與焊盤(pán)未完全融合)、短路(相鄰焊球粘連)。盡管2d圖像存在陰影重疊問(wèn)題(如多層焊點(diǎn)),但通過(guò)多角度拍攝(如0°、45°、90°)或圖像增強(qiáng)算法,可有效區(qū)分真實(shí)缺陷與陰影干擾。例如,通過(guò)調(diào)整x射線(xiàn)角度,可準(zhǔn)確判斷BGA焊點(diǎn)中的“氣泡空洞”是否超過(guò)IPC標(biāo)準(zhǔn)(class 3產(chǎn)品要求空洞直徑≤30%)。
- 檢測(cè)精度:可識(shí)別0.1mm以下的缺陷(如微空洞、細(xì)裂縫),滿(mǎn)足高精度BGA焊點(diǎn)需求;

三、破壞性檢測(cè):工藝驗(yàn)證的“終極手段”
當(dāng)非破壞性檢測(cè)無(wú)法確認(rèn)缺陷或需驗(yàn)證工藝穩(wěn)定性時(shí),需采用破壞性檢測(cè),通過(guò)解剖樣品直接觀(guān)察焊點(diǎn)內(nèi)部結(jié)構(gòu),適用于新產(chǎn)品導(dǎo)入、工藝調(diào)試或批量問(wèn)題復(fù)盤(pán)。
1. 切片分析(cross-section):內(nèi)部結(jié)構(gòu)的“顯微鏡”
- 操作步驟:
- 取樣:從PCBA上切割包含BGA焊點(diǎn)的樣品(通常使用精密切割機(jī));
- 鑲嵌:用環(huán)氧樹(shù)脂將樣品鑲嵌,便于后續(xù)拋光;
- 研磨拋光:通過(guò)多級(jí)砂紙研磨和拋光,露出焊點(diǎn)橫截面;
- 顯微觀(guān)察:使用金相顯微鏡或掃描電鏡(sem)觀(guān)察焊點(diǎn)內(nèi)部結(jié)構(gòu),如焊球與焊盤(pán)的融合度(是否完全潤(rùn)濕)、空洞分布(位置/大小/數(shù)量)、裂縫位置(是否延伸至焊盤(pán))。
- 應(yīng)用場(chǎng)景:驗(yàn)證回流焊工藝參數(shù)(如溫度曲線(xiàn))是否合理,或分析批量虛焊問(wèn)題的根本原因。
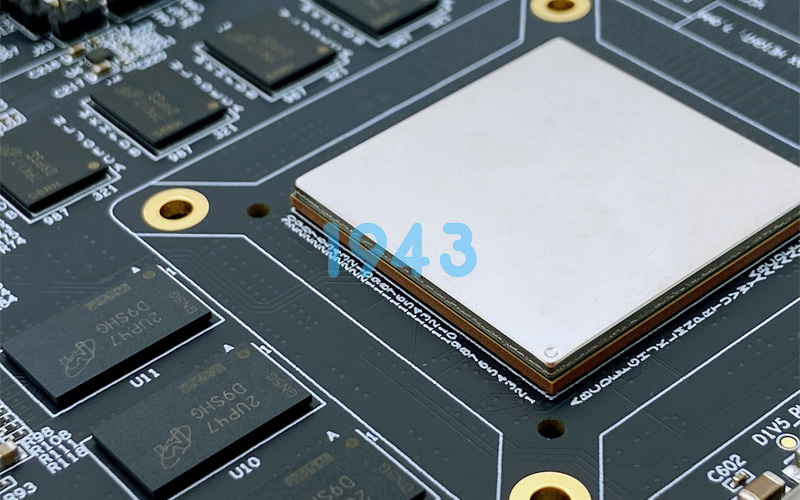
2. 拉力/剪切力測(cè)試:機(jī)械強(qiáng)度的“試金石”
- 原理:通過(guò)拉力測(cè)試機(jī)或推拉力測(cè)試機(jī),對(duì)BGA焊點(diǎn)施加垂直或水平力,測(cè)量其斷裂強(qiáng)度。
- 檢測(cè)內(nèi)容:
- 拉力測(cè)試:將BGA元件垂直拉起,記錄拉力值(如IPC-a-610g標(biāo)準(zhǔn)要求BGA焊點(diǎn)拉力≥10n);
- 剪切力測(cè)試:用刀片水平剪切焊點(diǎn),測(cè)量剪切力(如class 3產(chǎn)品要求≥50mpa)。
- 意義:評(píng)估焊點(diǎn)機(jī)械強(qiáng)度是否達(dá)標(biāo),避免因焊接不牢導(dǎo)致振動(dòng)或沖擊下脫落。
四、檢驗(yàn)標(biāo)準(zhǔn)與流程:如何落地執(zhí)行?
- 標(biāo)準(zhǔn)依據(jù):以IPC-a-610g《電子組件的可接受性》為核心,明確BGA焊點(diǎn)可接受標(biāo)準(zhǔn)(如空洞率、偏移量、拉力值);
- 流程設(shè)計(jì):
- 生產(chǎn)線(xiàn):AOI全檢 → X-Ray抽檢(高可靠性產(chǎn)品100%,普通產(chǎn)品按比例);
- 工藝驗(yàn)證:新產(chǎn)品導(dǎo)入時(shí)做切片分析,批量生產(chǎn)中定期抽檢;
- 異常處理:發(fā)現(xiàn)缺陷后立即停機(jī),通過(guò)X-Ray或切片分析定位根因(如 stencil設(shè)計(jì)、回流焊溫度)。
五、總結(jié):構(gòu)建“預(yù)防-檢測(cè)-改進(jìn)”閉環(huán)
BGA焊點(diǎn)質(zhì)量檢驗(yàn)需結(jié)合非破壞性快速篩查(AOI/X-Ray)與破壞性深度驗(yàn)證(切片/拉力測(cè)試),并嚴(yán)格遵循IPC標(biāo)準(zhǔn)。SMT貼片廠(chǎng)應(yīng)通過(guò)數(shù)據(jù)統(tǒng)計(jì)(如缺陷率、工藝能力指數(shù)cpk)持續(xù)優(yōu)化工藝,最終實(shí)現(xiàn)“零缺陷”生產(chǎn)。








 2024-04-26
2024-04-26

